芯片應用於終端系統上,需要將芯片焊接於PCB板上,與周邊相關元件、電路相互連接,共同組成系統板以提供全面的系統功能。然而在組裝上板之前,芯片須經歷運輸至組裝廠、儲存、上板等流程。在等待的過程中,因為暴露於車間的時間,使得芯片吸收了濕氣,而在高溫環境的回焊作業下,因為濕氣及溫度變化的影響,造成失效的情況發生。
Pre-con實驗主要在模擬芯片在運輸、上板使用等過程,所經歷的環境變化。

實驗流程:
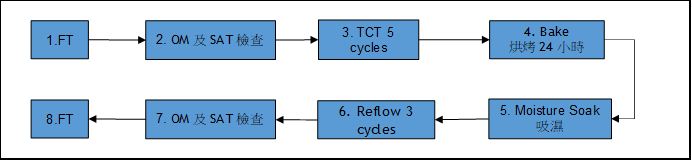
流程1、2,主要確認Pre-con前,初始的電性測試結果,以及芯片外觀、內部初始狀態,為Pre-con實驗前的初始數據。也將會作為Pre-con實驗結束後的數據比對用。
流程3,主要模擬芯片運輸過程中,陸、海或空運可能經歷的溫度變化,然而此測項因為運輸過程的不同,在規範中的定義是可以自行選擇執行與否。


流程4,主要模擬芯片上板前,去除封裝中的水份。使用爐溫125 度烘烤24小時,確保包裝拆封後芯片的狀態是乾燥的。
流程5,主要模擬芯片上板前,芯片包裝拆封後暴露於車間的時間,相關測試條件可參考J-STD-020,Table 5-1 Moisture Sensitivity Levels。
當芯片包裝拆封後等待上板的時間為168 小時,車間溫溼度條件為≦30 °C/60%RH的情況下。客戶可以選擇LEVEL 3的測試條件,以
30°C/60%RH溫溼度條件執行192小時的測試間,模擬該狀態。
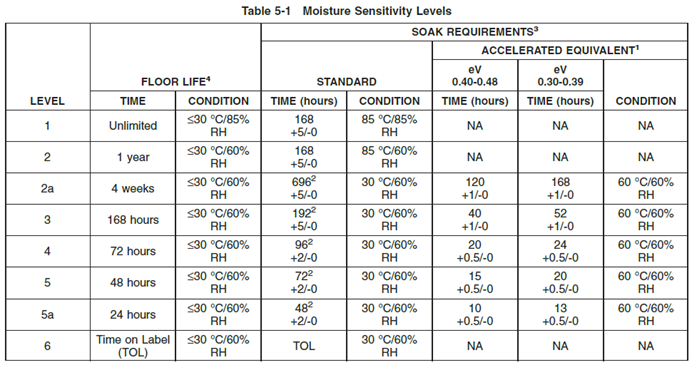
流程6,5主要模擬芯片上板時的狀態,相關測試條件可參考J-STD-020;規範中的4.1 Classification Temperatures (Tc)中的Table 4-1 &4-2 ,定義封裝厚度及體積選擇的Tc。


規範中的Table 5-2 及Figure 5-1定義Reflow執行條件。需要執行3次Reflow,依此模擬Reflow的過程,第一次是模擬雙面板A面回焊,第二次是模擬雙面板B面回焊,第三次是模擬組裝過程中”重工”再次回焊或是維修過程中類似回焊的溫度。


流程7、8,主要確認Pre-con後,封裝內部及外觀狀態,以及電性測試結果,並與Pre-con實驗前的數據比對。可進一步確認Pre-con實驗後內部是否有脫層或其他異常現象,外觀是否有損壞,以及芯片功能是否異常。依此評估芯片組裝過程中,可能面對到的失效問題。
Pre-con實驗是封裝可靠性測試的基礎。
JESD47規範中定義”必須先執行完Pre-con實驗後,才能進行THB、HAST、UHAST、TCT及AC等相關實驗項目”。 透過此實驗加上其他各項封裝可靠性測試項,讓各種不同機理的潛在失效發生,進而改善工藝以確保芯片封裝之可靠性。